|
|

引言
5 i, ?9 L! F- F$ n7 K9 j/ m6 K扇出型晶圆/面板级封装(FOW/PLP)是先进的封装技术,与传统封装方法相比,能够实现更高的I/O密度和更好的电性能。本文概述FOW/PLP技术,包括关键工艺步骤、应用和可靠性考虑因素。) h. J5 J6 b1 p' X" h* B
1 n# _- z9 R9 n7 F1 M+ [
扇出型封装简介
k, c' R4 E3 ]扇出型封装与扇入型晶圆级芯片尺寸封装(WLCSPs)的不同之处在于它需要在加工过程中使用临时载体。这允许重布线层(RDLs)延伸到原始芯片边界之外,从而实现更高的I/O数量。
. ?# M& g$ S& F) m, A* |; i
- o- Q2 G. [/ u% ]) m8 I% `) C5 f如图1所示,扇出型封装的步骤包括:将已知良好芯片(KGDs)拾取并放置在临时载体上用模塑料封装芯片在封装芯片上制作重布线层贴装焊球移除临时载体并将个别封装切割分离
" q: V) Y' K" B, T6 ~; d[/ol]
6 k4 W( J/ q r, }; _6 X$ v3 T! Y/ z1 `% `
md1mmo2vtfa64034868741.png
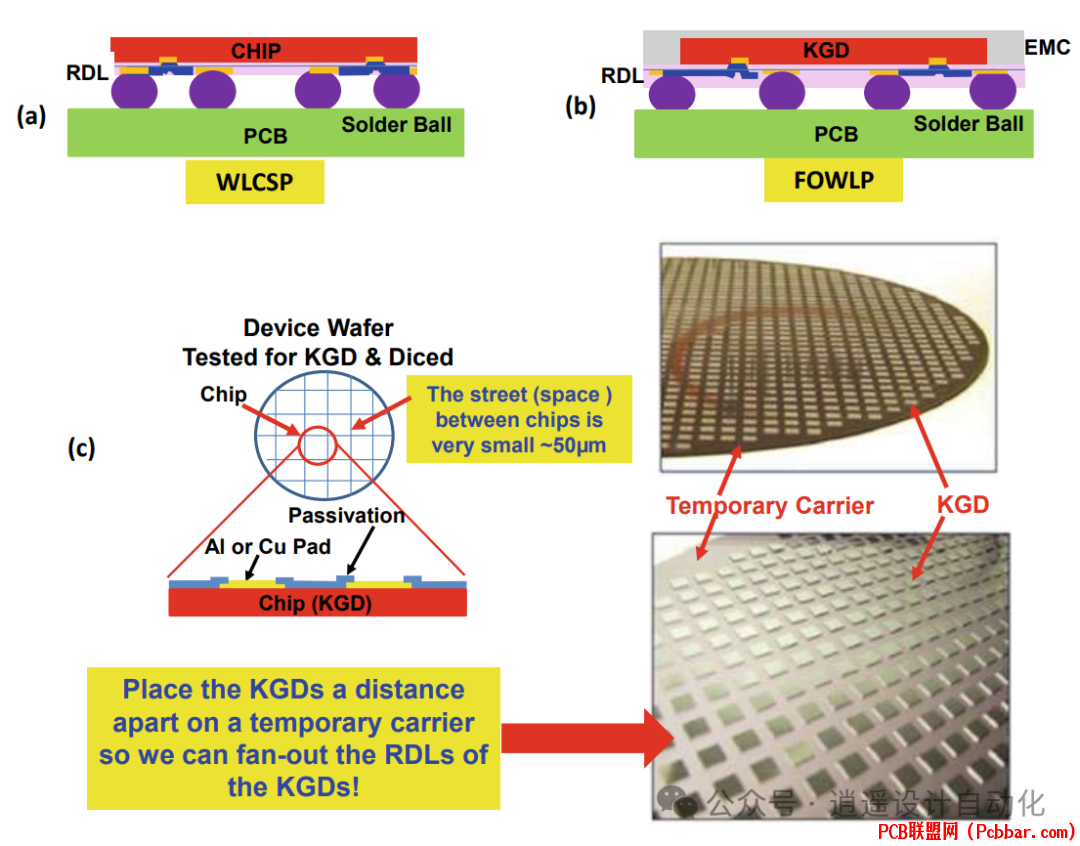
$ {8 t1 y& Q$ R8 k: l w- U图1
' ]7 |) N) r3 B0 E( J) j, W( M; S% M6 e; G
扇出型封装的主要优势包括:0 u- k2 b6 l5 L- t
更高的I/O密度改善的电性能更薄的封装厚度异质集成多个芯片的能力5 |5 d! V: c2 h
" L6 g( U$ I* h
扇出型晶圆级封装工艺流程! W: c" N W# R2 X
典型的扇出型晶圆级封装(FOWLP)工艺流程包括以下关键步骤:
: f3 t% ^" M$ h; E4 F! |' c晶圆准备和切割芯片贴装到临时载体模塑/封装载体移除重布线层制作焊球贴装和切割分离
7 `& g$ U7 ]$ A0 h/ g) G: v* g/ N2 w4 Z, O' v; I% [
图2提供了芯片优先、正面朝下FOWLP方法的这些工艺步骤的视觉概览:' _5 y; g- h% R0 J# z: e
& b/ W o* j; c% _1 S* \9 _
1txfsuovljy64034868841.png
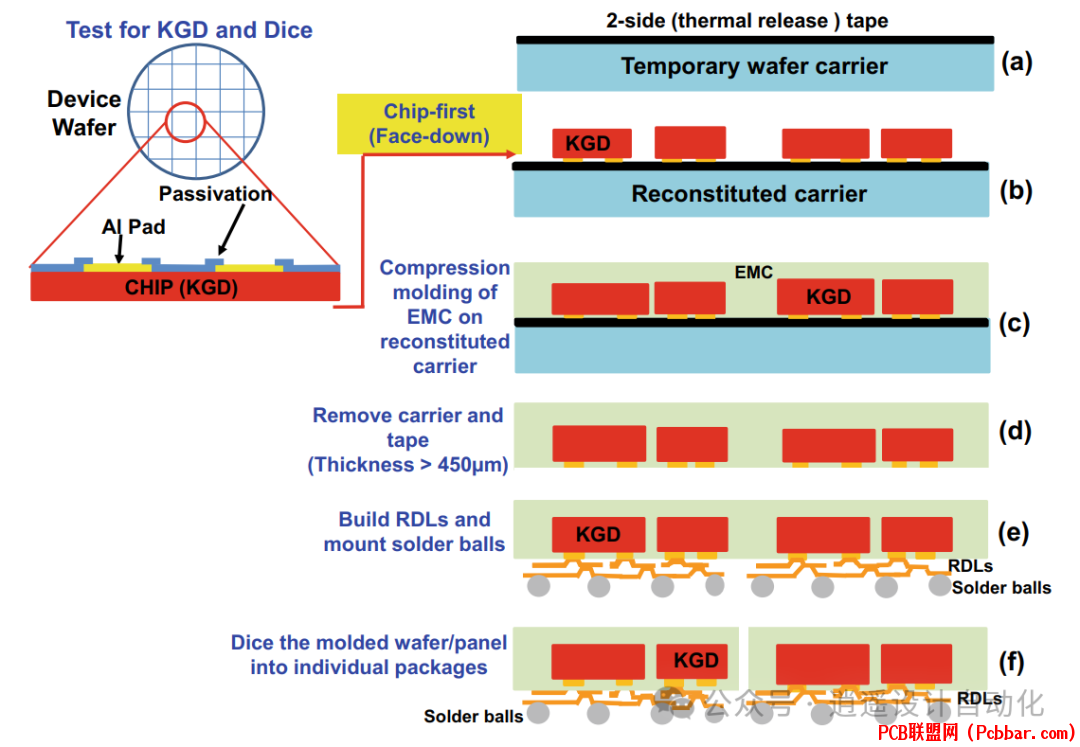
# [" Q; } V! E' u& P) v图2
4 h; V. o" D1 l0 `: f
; l. z5 C; z# O& A6 r8 U9 b) IFOWLP加工中的关键考虑因素包括:
3 M9 {# Q2 i5 ]( w0 ?7 x9 u. ~临时载体选择(玻璃、硅、金属)模塑料性质重布线层制作(线宽/间距、通孔形成)模塑过程中的芯片位移翘曲控制
! J6 I9 [& d# ^& Z! c7 r" j+ I. q9 z
扇出型面板级封装
" J4 G5 I1 g2 ~* N8 `7 [为了进一步提高产量并降低成本,扇出型加工可以扩展到大型矩形面板而不是圆形晶圆。这被称为扇出型面板级封装(FOPLP)。. U' V) g1 g% Y- t; Y0 G
7 g, \& W; ]& e3 Y2 W
图3展示了508 x 508 mm面板的例子,其中包含1512个扇出型封装:
5 S; J* m* R9 o' k6 V5 f8 m- I* @! p6 h& Q
tbczw3nsib064034868941.png
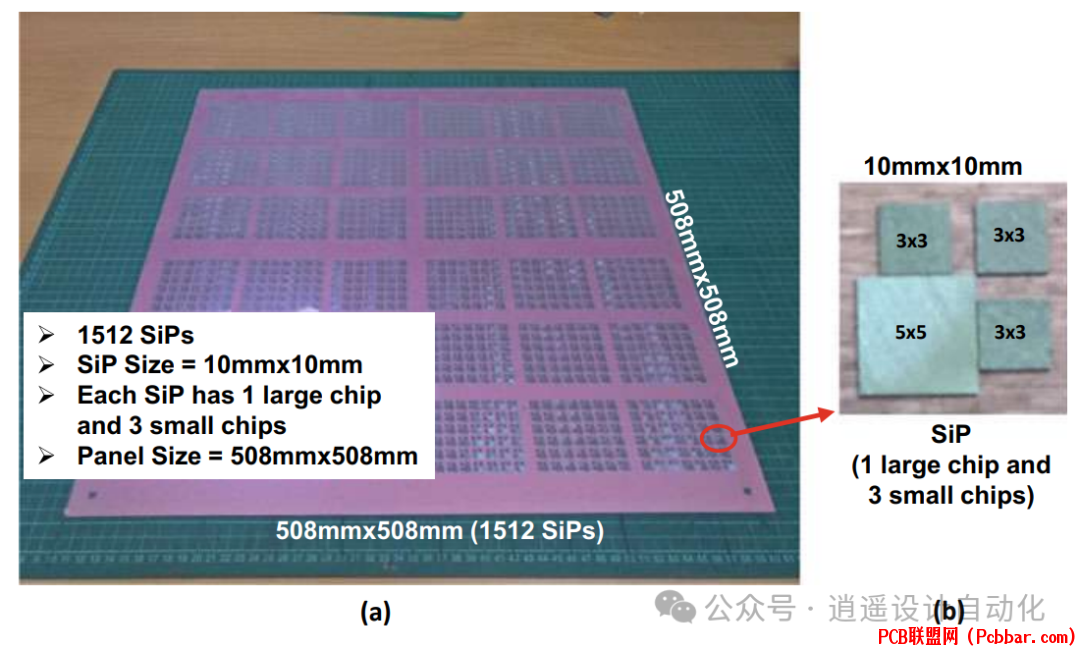
$ P) H B1 n8 U* I6 m* u图3
% h0 k' u! g$ r
/ h+ D8 T% [0 j2 X# b2 n$ N3 ^FOPLP的主要优势包括:
+ z6 A. W& [; I更高的产量更低的每个封装成本利用PCB/显示器制造基础设施( T# h' R6 x. f% |' f
# x) S1 C1 ~7 ?0 y
然而,像翘曲控制和维持大面板上的均匀性等挑战必须得到解决。
. J+ C! B- F4 _3 u1 b- Y) v' x9 l( ]& X
重布线层制作
6 M) t& d1 W' c扇出型封装的一个关键方面是细间距重布线层(RDLs)的制作。这通常涉及:介电层沉积/图案化种子层沉积光刻胶图案化铜电镀种子层去除
3 t! m- a: z7 W[/ol]; R3 `* r; p" H5 g
图4显示了扇出型封装中10 μm线宽/间距RDLs的扫描电镜图像:7 ~+ _: J# Z6 F( r/ j! m$ R
: E; k# i8 z5 M: j4 W4 W7 |0 k
hgx1qzn0wlw64034869041.png
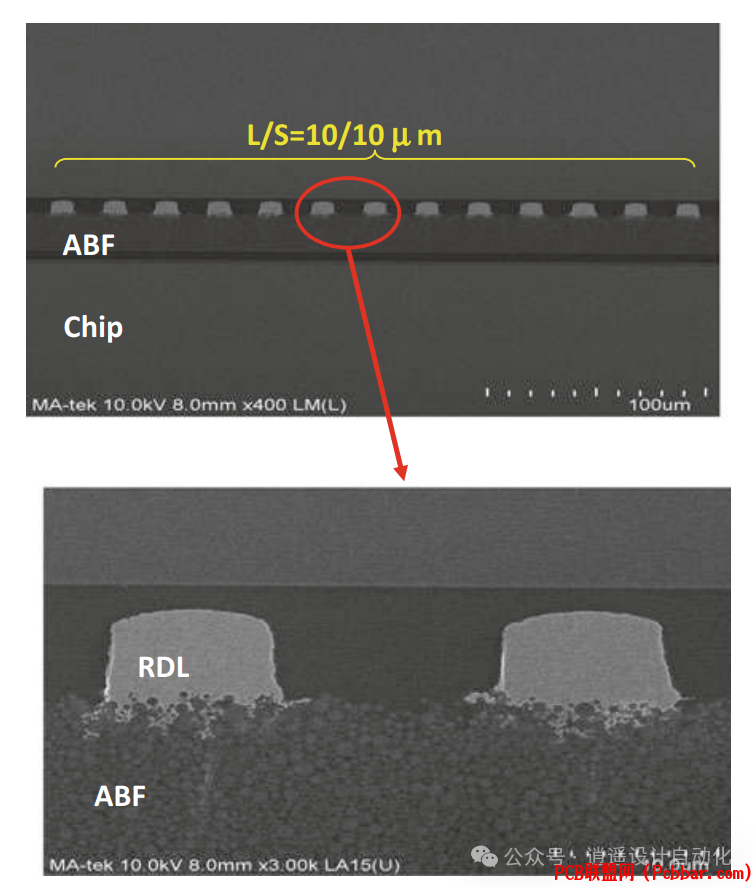
5 r/ Z/ ^$ N0 U; F0 a6 d% x图4$ @+ N; @( Y& b* ]/ s
先进的扇出型封装可能包含多个RDL层,线宽/间距尺寸可达到2/2 μm。
+ X8 m5 A; M9 `8 u. \/ l# Q4 A6 {! w. [+ d$ S
芯片后置与芯片优先方法* @3 {: F$ [ A8 _- v3 W
扇出型封装可以使用芯片优先或芯片后置(RDL优先)方法实现:
% e+ s, O: H1 v1.芯片优先:
) P; w8 i, L* C在RDL制作之前将芯片贴装到载体上成本更低,产量更高更容易发生芯片位移
+ j% M j! n) X9 ?3 a
5 K6 z; r2 W0 o$ W. s2.芯片后置:
- L4 u) x" G, p3 V& t" \在芯片贴装之前在载体上制作RDLs更好的尺寸控制成本更高,工艺步骤更多) U/ F6 q4 [$ p7 k: C+ \ I! T
: [4 X0 P" i! D7 ]
图5展示了RDL优先FOWLP方法的工艺流程:7 F$ t' s, X4 x6 |6 d
8 C3 ]* P. r" M
bi41l5yrhxm64034869141.png
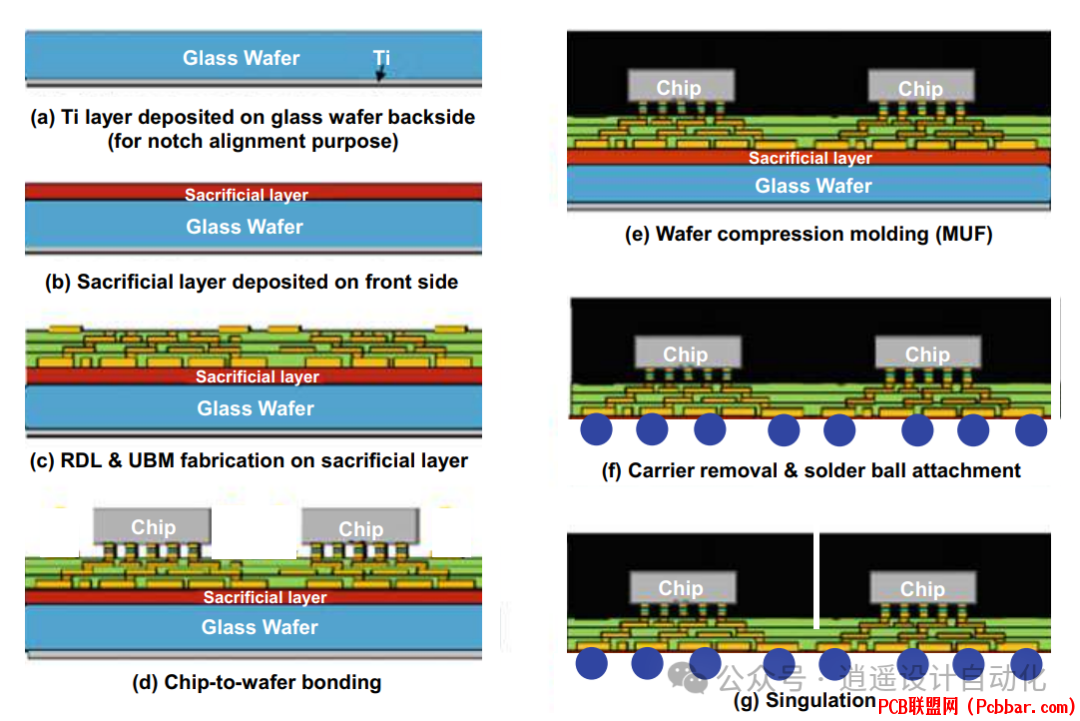
4 c6 d5 l# h4 ~/ i: Z* Q! s( @图5
- d, v8 Q9 i' B$ E9 {! w: G' Q7 h! e6 ?8 i! R
芯片优先和芯片后置之间的选择取决于成本、尺寸控制要求和芯片尺寸/间距等因素。4 M; S1 |0 {, f W# X
& o( W) D! j9 H3 g# I# B6 c0 R3 B异质集成
& C3 @3 \+ r* U, [. `扇出型封装的一个主要优势是能够在单个封装中集成多种类型的芯片。这使得以下组件的异质集成成为可能:3 F4 C$ O3 J1 L; r z) C9 ?) K
逻辑 + 存储器模拟 + 数字处理器 + 传感器
2 m0 W& ?2 p6 K M8 ?; s- n8 X6 A3 O9 f5 m2 \$ S" O/ x' i, G
图6展示了一个集成多种芯片尺寸的异质扇出型封装示例:
, u' M# o% K$ L, c+ O- J7 {
+ V+ v6 s( Q( v$ B* ^9 m: w! d
rqo0cfun1bt64034869241.png
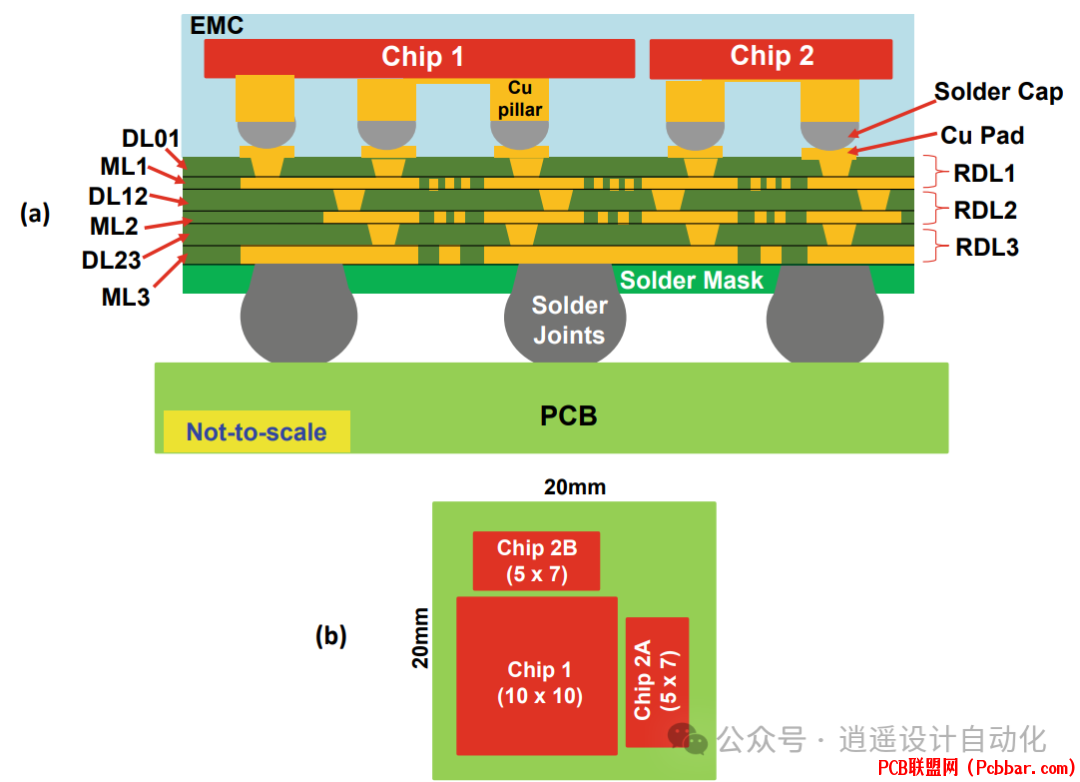 6 D6 G0 s6 o: W5 R- |$ g9 @
6 D6 G0 s6 o: W5 R- |$ g9 @
图6
2 ^8 ^" H3 D0 D- O; \1 g8 }1 Y
5 B# g! F: ~2 d6 c在异质扇出型设计中,必须仔细考虑芯片放置、RDL布线和热管理。
4 _. h3 ?4 L9 }! q6 a6 b$ O2 P
可靠性考虑# l2 G t9 Y! J8 X/ z( \
扇出型封装的主要可靠性问题包括:( o. [2 G+ ~+ Q: R2 h; g8 z
模塑过程中的芯片位移翘曲RDL裂纹/剥离焊点疲劳湿敏度
; n- G2 d. d: w3 ~
% J# a5 {# [9 H' x可靠性测试通常包括:( y1 r$ g% n7 p% q: ^
温度循环跌落/冲击测试湿敏等级(MSL)测试
; l* J; v9 w# m" [" N2 L8 v) l
/ w( F; J& g" ?5 x" f! b6 P图7展示了温度循环后扇出型封装中的焊点裂纹示例:9 M I$ e8 v) k; X7 ^
2 j' S" q0 A$ {
haekawl0xkc64034869342.png
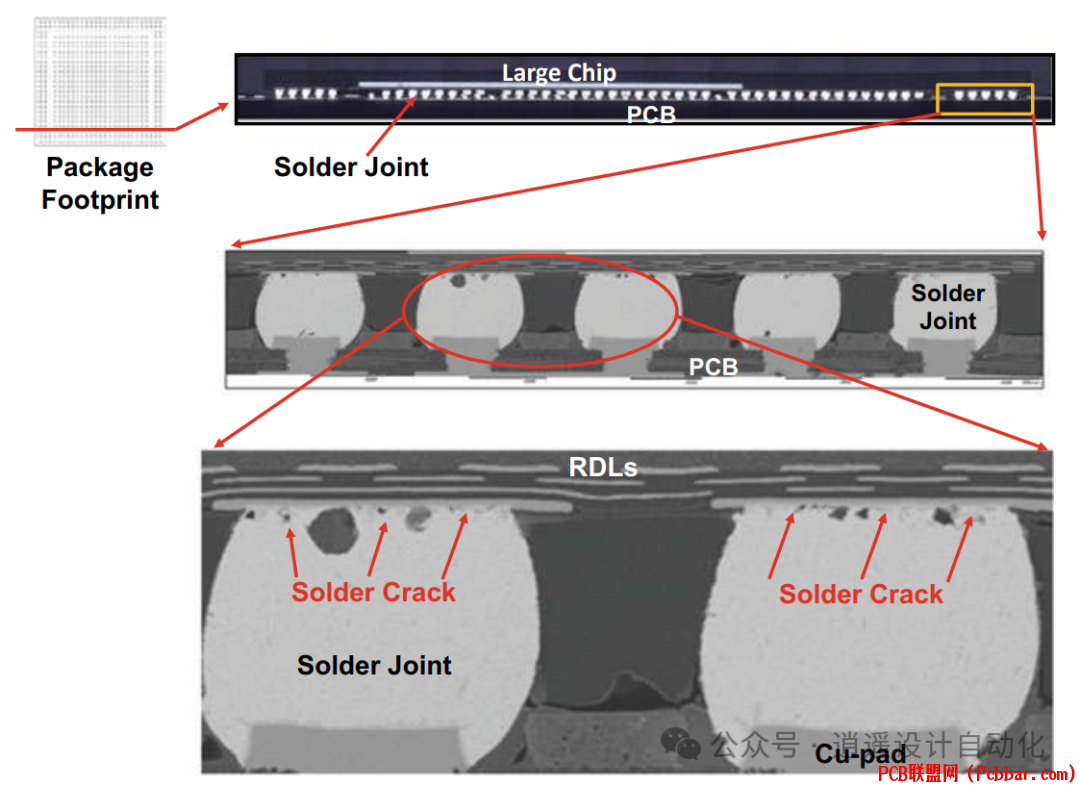
" G W% w& `/ B9 d, W图7. p- y5 f6 V' Z+ P$ N
7 s& Q& N8 ?$ h- O. _有限元建模通常用于分析应力和预测可靠性,如图8所示:+ V3 b/ Z( I, T, q
' d- @7 v3 M9 k
iwtkprskvil64034869442.png
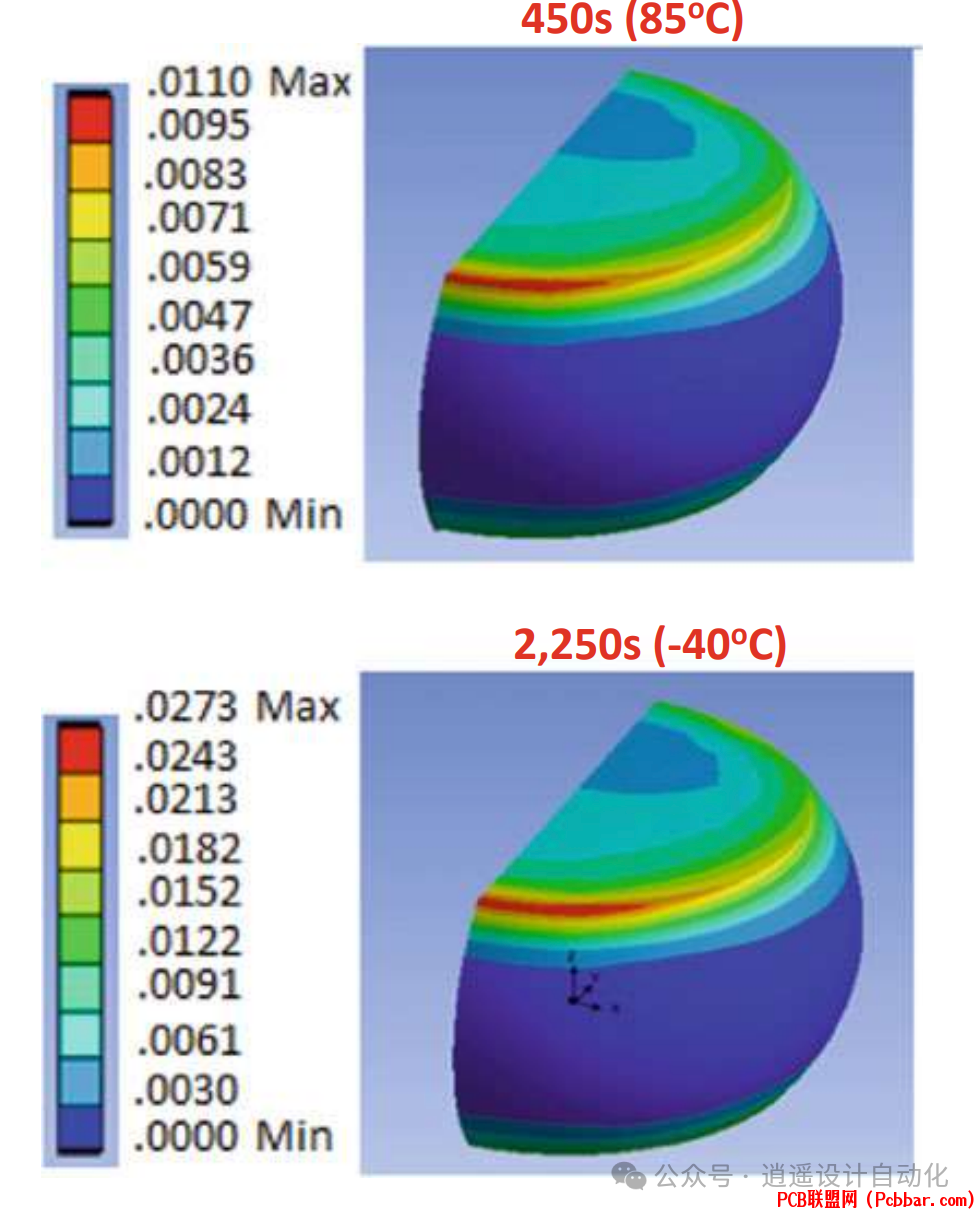
p& R2 V1 y1 m" v. S1 W' v图83 i' I7 z" }* Z1 J) {
! t# a- `* ~! r* F2 u: p4 r) B1 F. U
新兴应用:Mini-LED显示器
& m' @) P7 t( o4 W+ P" C扇出型封装的一个新兴应用是在mini-LED显示器中。扇出型封装允许超细间距集成mini-LED阵列。
: B. {8 C) }6 Z: c& D. c' P( {6 L. N" C
图9展示了使用扇出型技术封装的mini-LED阵列示例:
# p0 N" Z# `( C: ~. t
4 X* h/ W& ?4 ?7 \8 Z- L4 m$ L
w5q1gnho51f64034869542.png
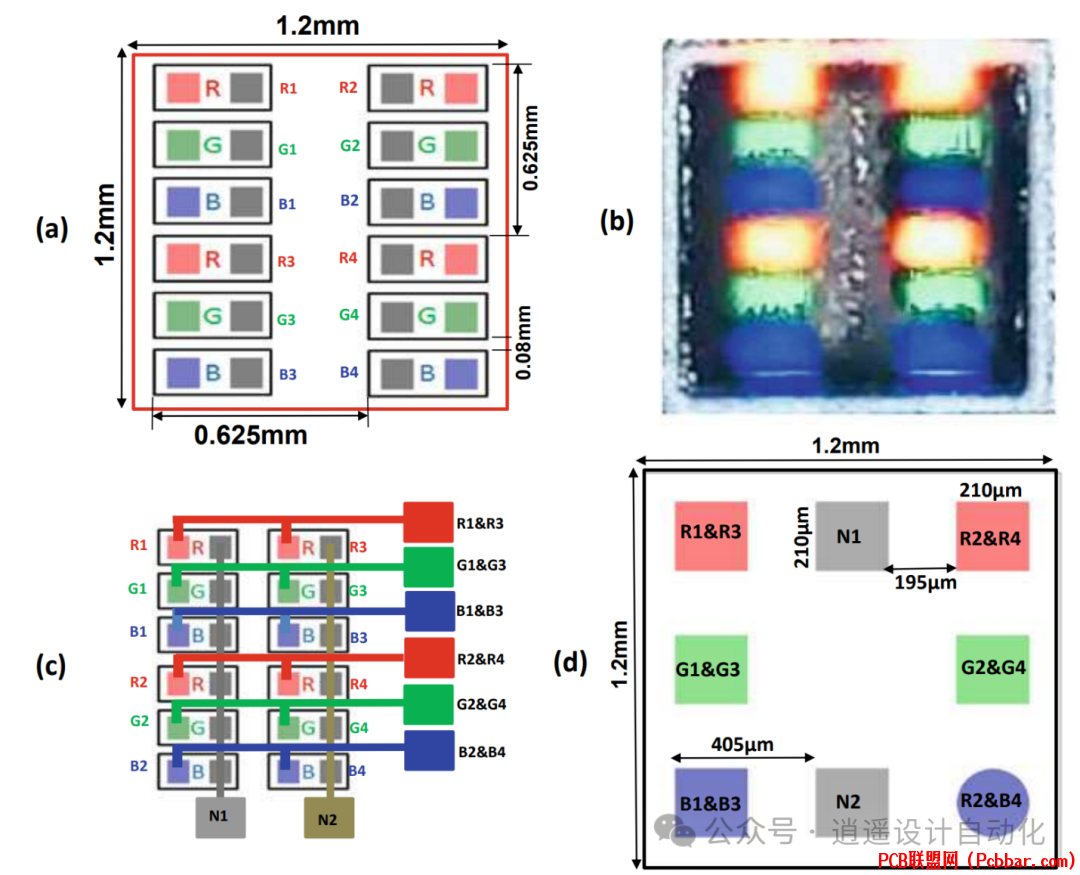
# w/ `% M# m( e" m/ a( H图9
; u! z& D3 o7 L+ a# g
9 `8 Z# w( q! K; Q3 Tmini-LED封装的主要优势包括:
1 \) z; p) f* A* ^4 S; |4 b, h超细间距能力(改善的热性能更低的封装厚度
1 I/ q t- l+ d+ A7 z& k. u3 A2 R/ s ^, B7 o3 J
图10展示了集成在扇出型封装中并安装在PCB上的mini-LEDs的横截面:
) D2 K7 Z) N2 O, F' B# P3 s; E* w% c6 P# W& x
djqkyjijfbq64034869642.png
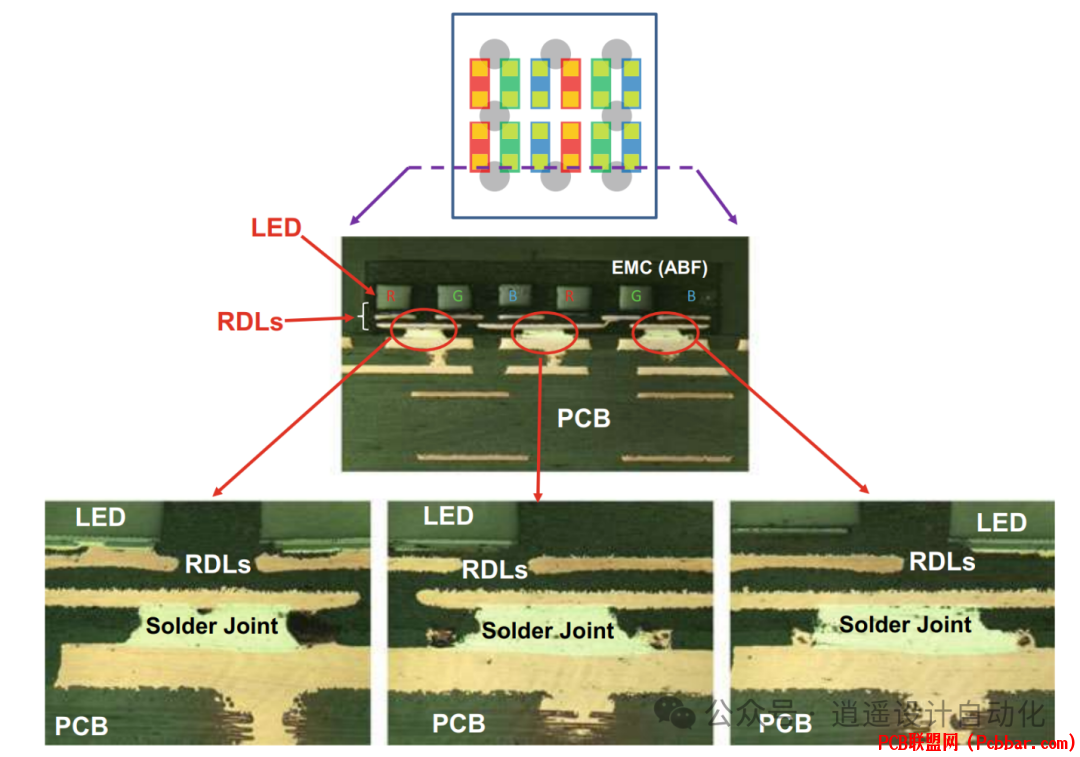
" M( \, a: G9 ]9 R图10
6 t) x- r8 }* W( z: a$ i6 C2 I" B( S9 m+ R9 c% i! ^" n, q6 _' s
总结 S; p8 ]% X( |0 n3 E+ x; {
扇出型晶圆/面板级封装与传统封装相比,能够实现更高的I/O密度、改善的性能和异质集成。主要方面包括:
/ i2 C+ g- w/ x" z5 @使用临时载体RDL制作芯片优先与芯片后置方法扩展到面板级以提高产量可靠性考虑
; B+ V8 b3 Q! E* A9 x7 y5 ], h2 |3 D _1 h3 g& `; d6 h
像mini-LED显示器这样的新兴应用展示了扇出型封装对下一代电子产品的优势。随着传统封装的缩放达到极限,预计扇出型技术将在先进电子系统中发挥越来越重要的作用。
9 X2 e1 X( U- c' q/ i
0 G5 X. _4 K+ p( B5 Q参考文献5 Z8 {& V1 r$ i7 G
[1] J. H. Lau, "Fan-Out Wafer/Panel-Level Packaging," in Semiconductor Advanced Packaging. Singapore: Springer Nature Singapore Pte Ltd., 2021, ch. 4, pp. 147-228.: ~9 @: S: K8 t3 Z5 @2 w
# v. d$ P7 f" U( s+ Q
- END -. ?5 M/ F6 v; F& _% Q
5 U- R5 w. o1 } U; g5 M2 U( d
软件申请我们欢迎化合物/硅基光电子芯片的研究人员和工程师申请体验免费版PIC Studio软件。无论是研究还是商业应用,PIC Studio都可提升您的工作效能。2 C2 o. P1 l U" I& X4 R
点击左下角"阅读原文"马上申请. b5 n7 X; b# y; Y! t1 d
: e( [8 v- y) W, M5 z欢迎转载- O; Y+ @7 i4 m9 X' R4 e
6 `; ^" t0 y5 y+ {- v/ L8 v( S' ~转载请注明出处,请勿修改内容和删除作者信息!
" s$ l- @/ ]2 d5 c! N. g0 t" @" H8 w/ S$ G3 e! w6 W
* y" o4 P/ r W0 D8 K% [3 A1 Q: a5 Z. X k% m. t' O& L5 x @
4geajoomnid64034869742.gif

' n9 B5 U. w! V
* e* r; s' C4 W5 q! B8 \5 o% f关注我们
% ~2 Q) e( l0 W( R/ k
8 j8 o; z! T" N7 u6 x* X1 V' `) O0 I, \, G
i0ke4hzpybc64034869842.png

" J/ _4 j. B; K h! H; H: n | Q# x' u, G" b
e0gykyk3vw264034869942.png
 1 f( R; J" A1 d$ l7 p$ L
1 f( R; J" A1 d$ l7 p$ L
| * A( m( x* [) z" Y# a
vfbxux12rq464034870042.png
 + P( C% f, m% d
+ P( C% f, m% d
|
# ?3 G% Y5 O( j# l7 S4 C
2 v; I: ^' H9 L7 }" z/ X% d$ n+ F" q' |$ Y9 g6 Z+ Y$ t
- U( J0 H& B- X3 _! m$ Z7 m2 Y关于我们:
" Q7 z; l. `- o8 P深圳逍遥科技有限公司(Latitude Design Automation Inc.)是一家专注于半导体芯片设计自动化(EDA)的高科技软件公司。我们自主开发特色工艺芯片设计和仿真软件,提供成熟的设计解决方案如PIC Studio、MEMS Studio和Meta Studio,分别针对光电芯片、微机电系统、超透镜的设计与仿真。我们提供特色工艺的半导体芯片集成电路版图、IP和PDK工程服务,广泛服务于光通讯、光计算、光量子通信和微纳光子器件领域的头部客户。逍遥科技与国内外晶圆代工厂及硅光/MEMS中试线合作,推动特色工艺半导体产业链发展,致力于为客户提供前沿技术与服务。
3 k; ]# Z/ A& E$ j5 H7 `) q2 j' \2 h) Y! f3 P
http://www.latitudeda.com/
" C1 M" Q* t" F7 k+ V; a a# p5 O& t3 x(点击上方名片关注我们,发现更多精彩内容) |
|